

Standard Binary Mask(二元掩模版也称为双极型掩模),是指由透光与不透光两种部分组成的光掩模版,是目前最广泛的光罩产品,其广泛用于365nm(I线)至193nm(ArF)的光刻工艺中,可覆盖的制程为130nm及以上的工艺节点。
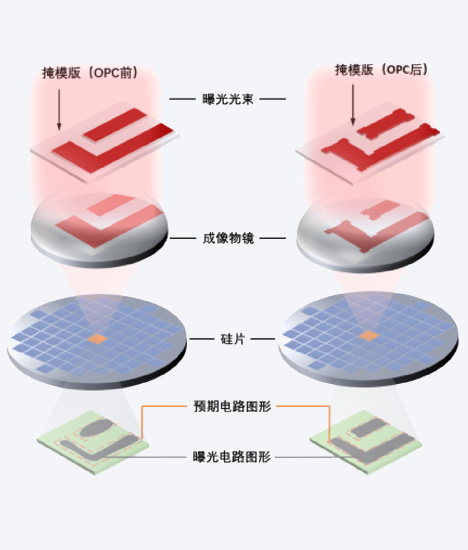
OPC(Optical Proximity Correction)即光学邻近效应修正技术,是一种光刻分辨率增强技术。在芯片制造过程中,当关键图形的尺寸小于光源的波长时,光的衍射效应导致掩模投影至硅片上的图案边缘失真严重,因此需要对掩模图案进行设计上的修正和补偿,以此提高晶圆曝光时的图形分辨率与图像准确度。公司目前可应用多项 OPC 技术,并与客户密切合作,开发符合客户工艺要求的OPC光罩。

PSM(Phase Shift Mask)即相移掩模技术,其通过MOSi层产生180°的相位差,可以降低光的衍射作用,提高光罩图形的分辨率,增大焦深。公司初步研发了180nm工艺节点关键层的PSM掩模版技术,并将与客户密切合作,进一步开发符合要求的PSM掩模版。